
在陶瓷基板金屬化工藝中,直接鍍銅(DPC)技術(shù)憑借其高線路精度(線寬/線距可低至50μm)、優(yōu)異的導(dǎo)熱性(氮化鋁基板熱導(dǎo)率≥170W/mK) 以及低溫制程優(yōu)勢(<300℃),已成為大功率半導(dǎo)體封裝的首選方案。而電鍍銅加厚作為DPC工藝的核心環(huán)節(jié),直接決定了基板的導(dǎo)電性、機械強度及長期可靠性。本文將深入解析其技術(shù)流程、關(guān)鍵控制點及行業(yè)創(chuàng)新方向。一、電鍍銅加厚工藝的技術(shù)定位電鍍銅加厚制程位于DPC工藝流程的中后期階段,其原理是將磁控濺射和化學(xué)沉銅形成的薄銅層(通常≤1μm)增厚至功能厚度(0.5–3.0OZ,約17–105μm),以滿足高電流承載、低電阻導(dǎo)通及三維互連需求。電鍍銅的質(zhì)量,直接決定基板的導(dǎo)電性、機械強度及熱管理性能。二、電鍍銅加厚的核心流程
1. 前處理:表面活化與清潔
微蝕粗化:使用酸性微蝕液(如H?SO?-H?O?)去除銅面氧化物,形成微米級粗糙度(Ra≈0.3–0.8μm),增強鍍層結(jié)合力。
酸洗除油:酸性除油劑清除有機污染物,防止電鍍空洞。
預(yù)浸活化:膠體鈀活化液(SnCl?/PdCl?)吸附于孔壁,為化學(xué)鍍銅提供催化位點,確保通孔(Via)導(dǎo)電連續(xù)性。
2. 電鍍銅工藝:精準增厚
電解液配方:以CuSO?(180–250g/L)和H?SO?(40–70g/L)為主液,添加光亮劑(如聚二硫二丙烷磺酸鈉)、整平劑(咪唑類衍生物)及抑制劑(聚乙二醇),調(diào)控鍍層致密性與平整度。
電鍍參數(shù)控制:電流密度:1.5–4 A/dm2(過低導(dǎo)致沉積慢,過高引發(fā)放氣燒焦);溫度:20–30℃(高溫加速添加劑分解);陰陽極比:1:1~1:2(避免邊緣效應(yīng))。
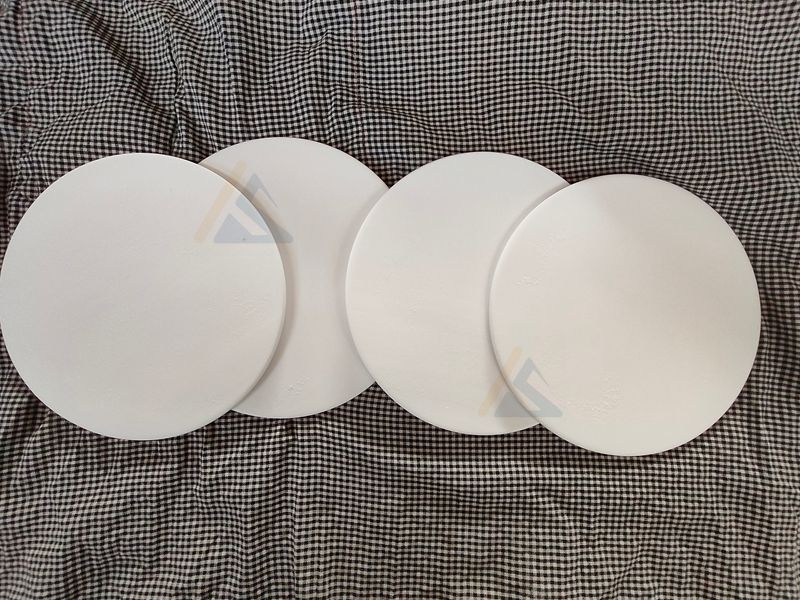
DPC陶瓷基板電鍍銅示意圖
通孔填充能力:采用脈沖電鍍或水平電鍍線,配合旋轉(zhuǎn)陰極設(shè)計,實現(xiàn)小孔徑(≥0.2mm)深徑比(≤8:1)通孔的無縫隙填充。
3. 后處理:應(yīng)力釋放與結(jié)構(gòu)強化
退火工藝:300–400℃氮氣氛圍中烘烤30–60分鐘,消除電鍍內(nèi)應(yīng)力,且提升銅層延展性(延伸率≥15%)及熱循環(huán)壽命。
表面研磨:砂帶打磨去除退火氧化層,Ra≤0.1μm,為后續(xù)阻焊/表面處理提供平整基底。
三、工藝瓶頸與創(chuàng)新解決方案1. 銅箔結(jié)合力提升激光微織構(gòu)技術(shù):在陶瓷基板表面進行激光掃描,形成微米級凹坑,增加機械互鎖位點;應(yīng)力釋放退火:在氮氣保護下以250–300℃退火2小時,使銅晶粒再結(jié)晶,延展性提升30%以上,同時消除電鍍內(nèi)應(yīng)力。2. 銅層厚度均一性控制旋轉(zhuǎn)陰極:在磁控濺射時,對基板旋轉(zhuǎn)實現(xiàn)雙面鍍膜厚度偏差<5%;自適應(yīng)電流分布:電鍍時,依據(jù)基板形狀動態(tài)調(diào)節(jié)陽極位置,補償電流邊緣衰減。

DPC陶瓷基板斷面SEM圖四、行業(yè)應(yīng)用與未來挑戰(zhàn)DPC電鍍銅加厚工藝已賦能多領(lǐng)域高功率器件。在新能源汽車領(lǐng)域,IGBT模塊銅層厚度≥100μm,可耐受300A瞬時電流。在5G射頻器件領(lǐng)域,金鍍層+銅基底層(沉鎳金工藝)可實現(xiàn)低插損信號傳輸。在激光雷達應(yīng)用場景,銅線路粗糙度(Ra<0.5μm)可提高VCSEL芯片的散熱效率。結(jié)語電鍍銅加厚工藝的精密控制是DPC基板高可靠性的基石。隨著封裝技術(shù)向多芯片集成、高頻大功率演進,工藝需持續(xù)優(yōu)化鍍層均勻性、界面結(jié)合力及熱管理效能。隨著新能源汽車、AI芯片對功率密度要求的躍升,超厚銅沉積(>200μm)等工藝技術(shù)的發(fā)展值得進一步關(guān)注。(更多資訊請關(guān)注陶瓷基板公眾號哦!)